非破壊・非接触でパワー半導体の電気特性を計測

テラヘルツ分光とは、光と電波の境界の周波数であるテラヘルツ(THz)の電磁波を用いた分光計測手法です。
Tera Evaluatorは、テラヘルツ分光測定にエリプソメトリの技術を導入した新しいテラヘルツ分光装置であり、4インチ・6インチウェーハの電気特性の計測を非破壊・非接触で実現しました。原理的には、全ての半導体材料へ適応可能です。
反射光学系の採用により、不透明な材料の測定に最適です。
ラインナップ
Tera Evaluator 標準モデル
Tera Evaluatorは、光と電波の境界領域という、今までとは取り扱いが異なる電磁波の帯域を取り扱う新しい分光装置です。電磁波パルスの電場強度の時間波形を計測することで、電場強度と共に位相情報も同時に計測します。
リファレンスとサンプルでの時間波形の違いを解析することにより、サンプルの複素誘電率(複素屈折率)の周波数依存性を得ることができます。
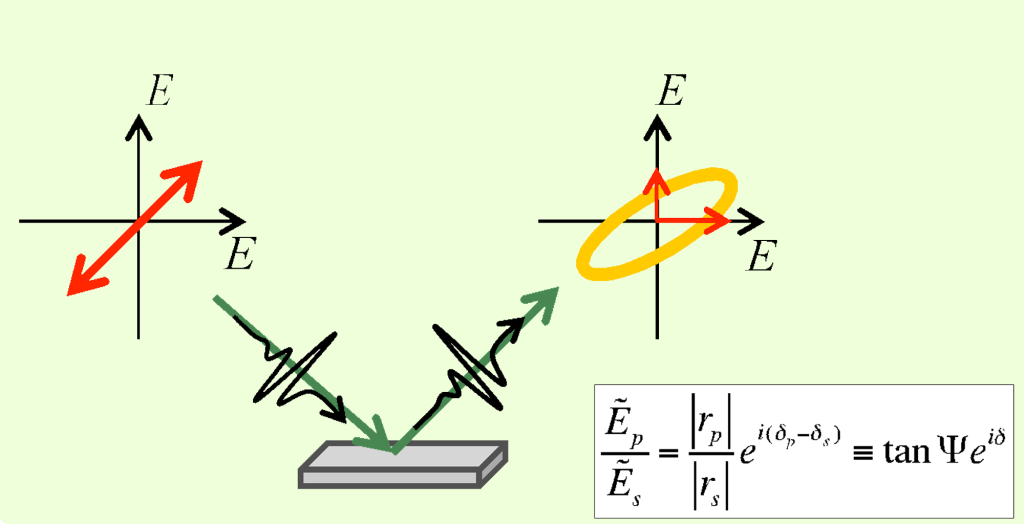

標準モデルでは、φ100mm・φ150mmウェーハ測定用マッピングステージを搭載していますが、φ300 mmウェーハまで対応可能(工場オプション)です。
測定例
SiC

SiC基板の色の濃い部分が「電気伝導度(キャリア濃度・移動度・抵抗率)の違い」として検出されます。
使用ソフト:THZELLIPS
出典:Agulto, V. C., Iwamoto, T., Zhao, Z., Liu, S., Kato, K., & Nakajima, M., “Wafer-scale mapping of carrier density and mobility with terahertz time-domain ellipsometry.” Optics Letters 50.3 (2025): 948-951.
Wafer-scale mapping of carrier density and mobility with terahertz time-domain ellipsometry
GaAs
GaAs基板
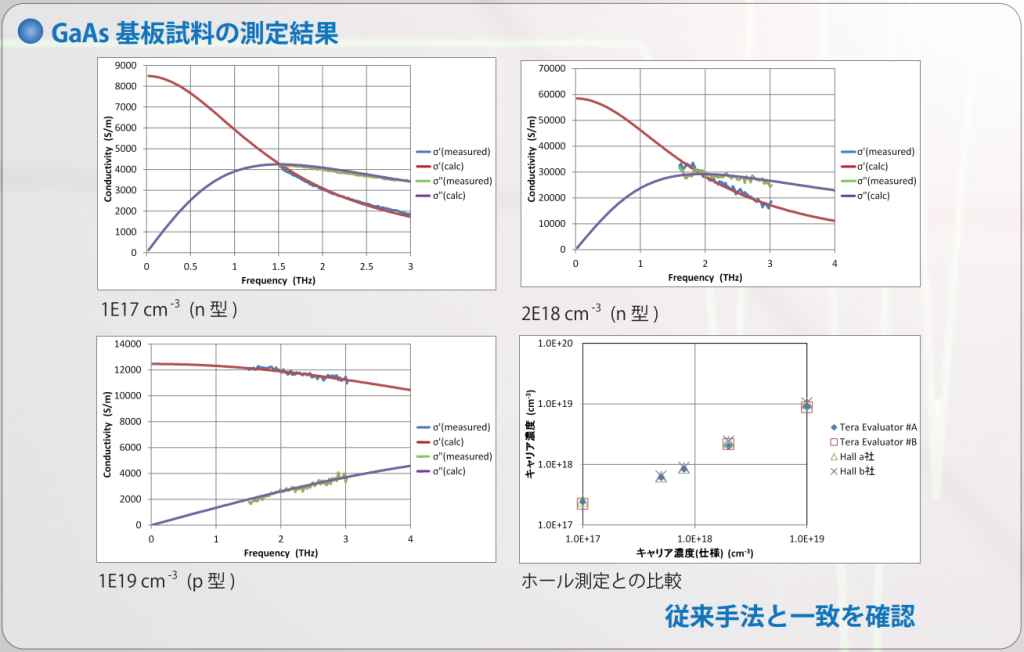
出典: Iwamoto, T., Agulto, V. C., Liu, S., Wang, Y., Mag-usara, V. K., Fujii, T., … & Nakajima, M., “Characterization of electrical properties of β-Ga2O3 epilayer and bulk GaAs using terahertz time-domain ellipsometry.” Japanese Journal of Applied Physics 62.SF (2023): SF1011.
Characterization of electrical properties of β-Ga2O3 epilayer and bulk GaAs using terahertz time-domain ellipsometry – IOPscience
GaAsエピ膜
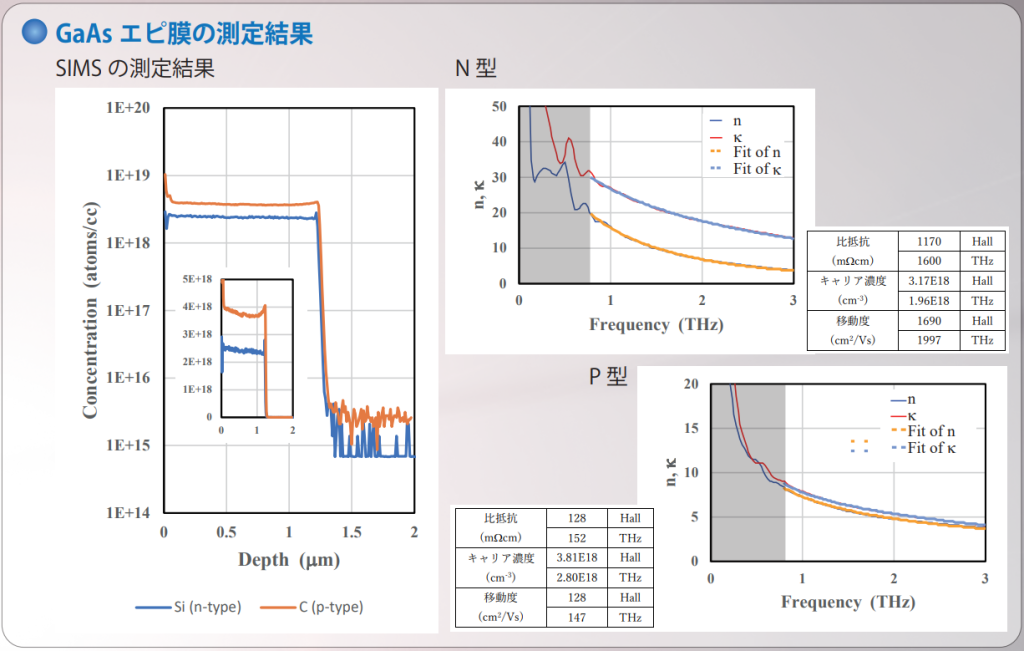
GaAs基板、エピ膜の測定結果は、従来の測定方法と比べ±10%の誤差で一致しています。
製品仕様・カタログ
| 測定方式 | THz Time-Domain Ellipsometry |
| 計測信号 | 電場強度の時間波形 |
| 出力データ | エリプソリックパラメータ、複素屈折率/誘電率/電気伝導度(解析プログラム使用) |
| 試料配置 | 水平配置(測定面:上面) |
| 試料サイズ | φ100, 150mm(工場オプションにより、φ200, 300mm対応可) |
| 測定帯域 | 1~3THz以上(標準試料による出力範囲) |
| フェムト秒パルスレーザ | 中心波長780~810nm付近、パルス幅120fs以下 (※外部からの導入も可能です) |
| 制御用PC | 標準ソフトをインストールしたWindows OSの動作条件を満たすコンピュータを付属 |
| ソフトウェア | 測定用ソフトウェア、解析用ソフトウェア |
| 外形寸法/重量 | W732×D585×H540mm、約125kg(※配線、突起等は含みません) |
| 電源 | AC100V(50/60Hz) 10A |
※販売形態・オプションについては別途お問い合わせください。
